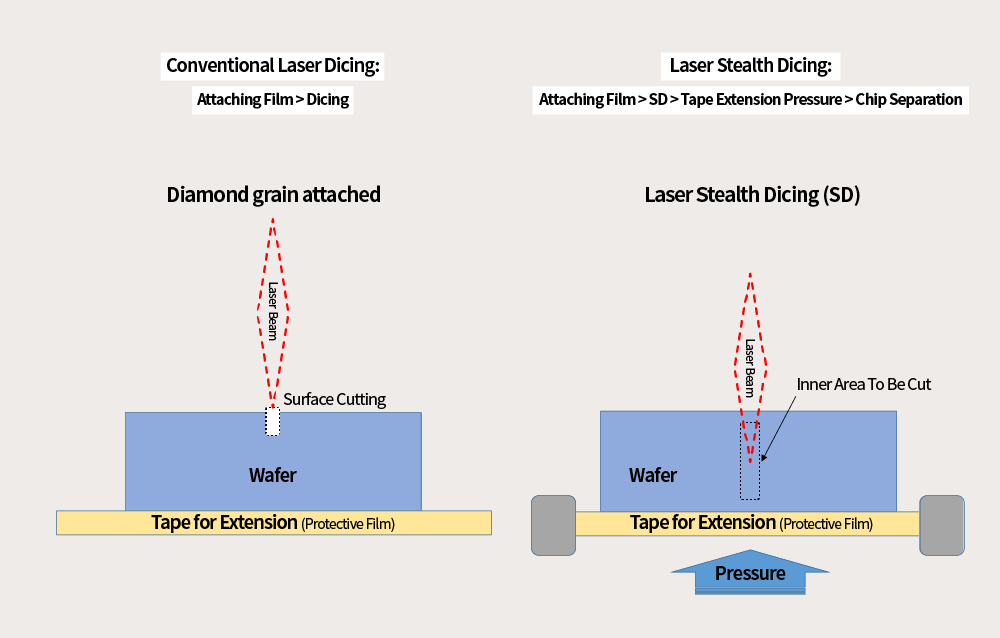
Singulation, the Moment When a Wafer is Separated into Multiple Semiconductor Chips | SK hynix Newsroom

Panasonic and Tokyo Seimitsu Enter into Joint Development to Promote Laser Grooving Device Used in Plasma Dicing Process|2017|ACCRETECH - TOKYO SEIMITSU

Multilayer stack materials on silicon-based wafer dicing processes using ultraviolet laser direct dicing and milling methods - ScienceDirect

Schematic illustration of “laser process” in Stealth Dicing (SD) When a... | Download Scientific Diagram
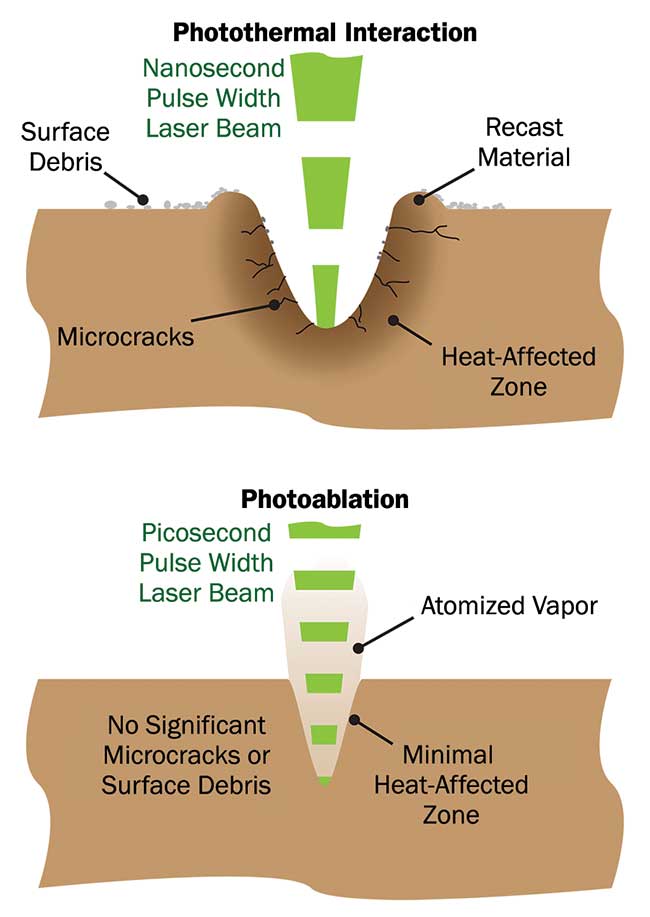
For Glass and Silicon Wafer Cutting, Shorter Pulse Widths Yield Superior Results | Dec 2016 | Photonics.com

Multibeam laser, an attractive and emerging laser technology for thin wafer provided by ASM Laser Separation International - i-Micronews
3D-Micromac unveils Clean Scribe technology on microDICE TLS laser micromachining system for particle-free dicing of SiC wafers


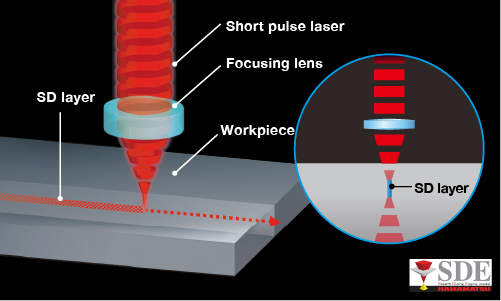
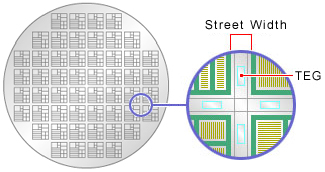



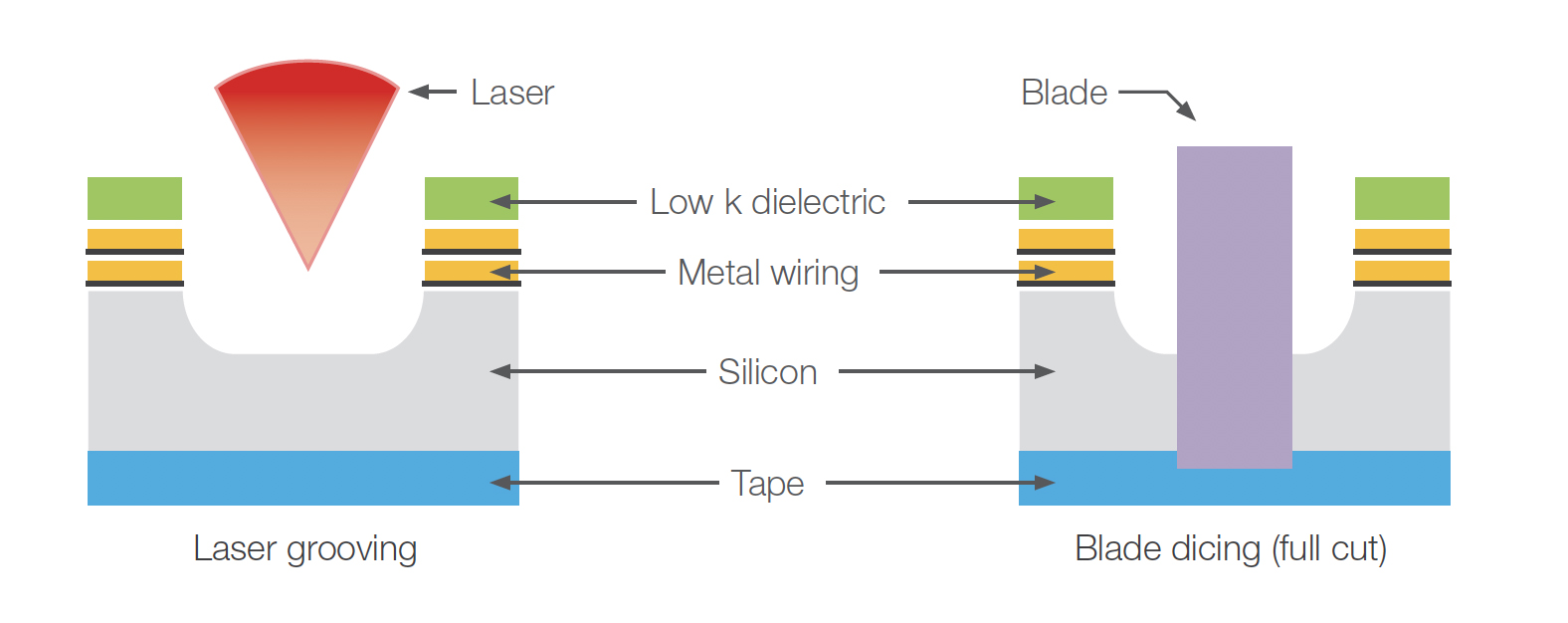





.jpg)